| 少子寿命对器件反向漏电流的影响机理 | 您所在的位置:网站首页 › 八极杆漏电流错误原因 › 少子寿命对器件反向漏电流的影响机理 |
少子寿命对器件反向漏电流的影响机理
|
目录
缺陷与少子寿命的关系晶格缺陷影响电子迁移率
当少子寿命较长时,少数载流子在P型区域和N型区域之间的漂移和扩散速度相对较慢,因此在反向偏置时,少数载流子会更容易被捕获而不会产生大量的反向漏电流,反之,当少子寿命较短时,少数载流子在P型区域和N型区域之间的漂移和扩散速度相对较快,因此在反向偏置时,少数载流子会更容易穿过PN结并产生反向漏电流。
缺陷与半导体材料中的少子寿命有密切关系。少子寿命是指在半导体材料中自由载流子(如电子或空穴)的寿命,即它们在材料中停留的时间。当材料中存在缺陷时,缺陷可以捕获自由载流子,使其从材料中消失,从而缩短少子寿命。具体来说,缺陷会: 捕获自由载流子:缺陷中的能级可以与自由载流子的能级相匹配,使得自由载流子被捕获并从材料中消失。 诱发复合:缺陷可以在自由载流子之间诱导复合,即电子与空穴相遇并互相抵消。 影响传输:缺陷会增加自由载流子的传输路径,从而降低载流子的迁移率和速度,进而影响少子寿命。 因此,缺陷会缩短半导体材料中自由载流子的寿命,从而影响器件的性能和可靠性。为了减少缺陷对器件的影响,需要采取措施来减少缺陷的产生,或利用技术手段来修复缺陷。 晶格缺陷影响电子迁移率晶格缺陷可以影响半导体材料中的电子迁移率。电子迁移率是指电子在半导体材料中的运动速度和行进方向,它是半导体器件中的重要性能指标。晶格缺陷会影响电子迁移率的原因是: 散射:晶格缺陷可以散射电子,从而影响电子的运动速度和方向。由于散射的影响,电子的平均自由程会减小,电子流的迁移率也会降低。 能级:晶格缺陷可以在半导体材料中引入新的能级,使得电子和空穴在晶格缺陷周围发生散射或复合,从而降低电子的迁移率。 空穴捕获:晶格缺陷可以在半导体材料中引入新的能级,使得空穴在晶格缺陷周围被捕获,从而降低电子和空穴的有效浓度,影响电子的迁移率。 因此,晶格缺陷可以影响半导体材料中的电子迁移率,进而影响器件的性能和可靠性。为了减少晶格缺陷对器件的影响,需要采取措施来减少晶格缺陷的产生,或利用技术手段来修复晶格缺陷。 |
【本文地址】
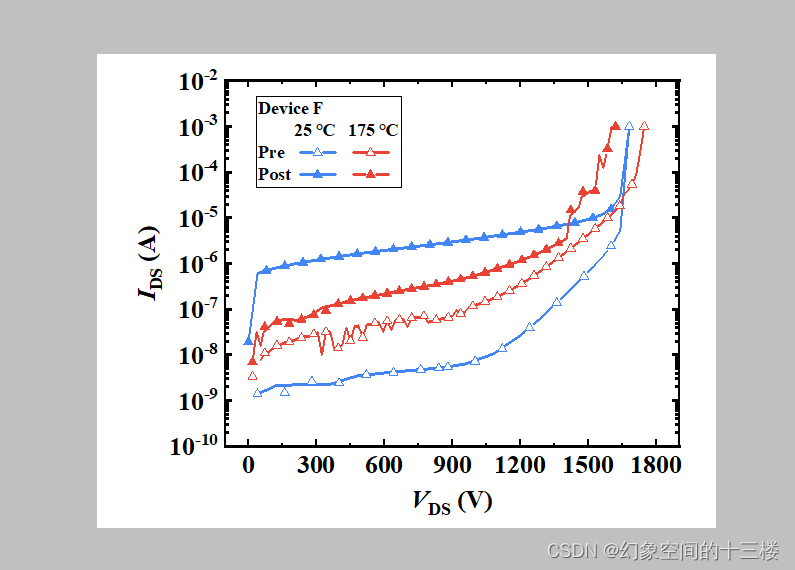 Pre没有缺陷,少子寿命长,反向漏电流小一些;Post有缺陷,少子寿命短,反向漏电流大;一般来说,温度升高,少子寿命缩短,反向漏电流变大;温度降低,少子寿命增大,反向漏电流减小。 上图的Ids,Vds是BV击穿特性图。25°C且没有缺陷的Pre少子寿命最长,反向漏电流最小,升高温度,漏电流会增加。Post有缺陷的情况下,升高温度,Ids反而降低,说明阻挡电荷陷阱或氧化物缺陷,它们可能会在高温下被激活或填充,从而降低Ids电流。相同温度时,因为Post有缺陷,少子寿命短,反向漏电流会更大。
Pre没有缺陷,少子寿命长,反向漏电流小一些;Post有缺陷,少子寿命短,反向漏电流大;一般来说,温度升高,少子寿命缩短,反向漏电流变大;温度降低,少子寿命增大,反向漏电流减小。 上图的Ids,Vds是BV击穿特性图。25°C且没有缺陷的Pre少子寿命最长,反向漏电流最小,升高温度,漏电流会增加。Post有缺陷的情况下,升高温度,Ids反而降低,说明阻挡电荷陷阱或氧化物缺陷,它们可能会在高温下被激活或填充,从而降低Ids电流。相同温度时,因为Post有缺陷,少子寿命短,反向漏电流会更大。