| 金属层间介质膜层的形成方法与流程 | 您所在的位置:网站首页 › rto工艺用于后端金属层间介质层生长 › 金属层间介质膜层的形成方法与流程 |
金属层间介质膜层的形成方法与流程
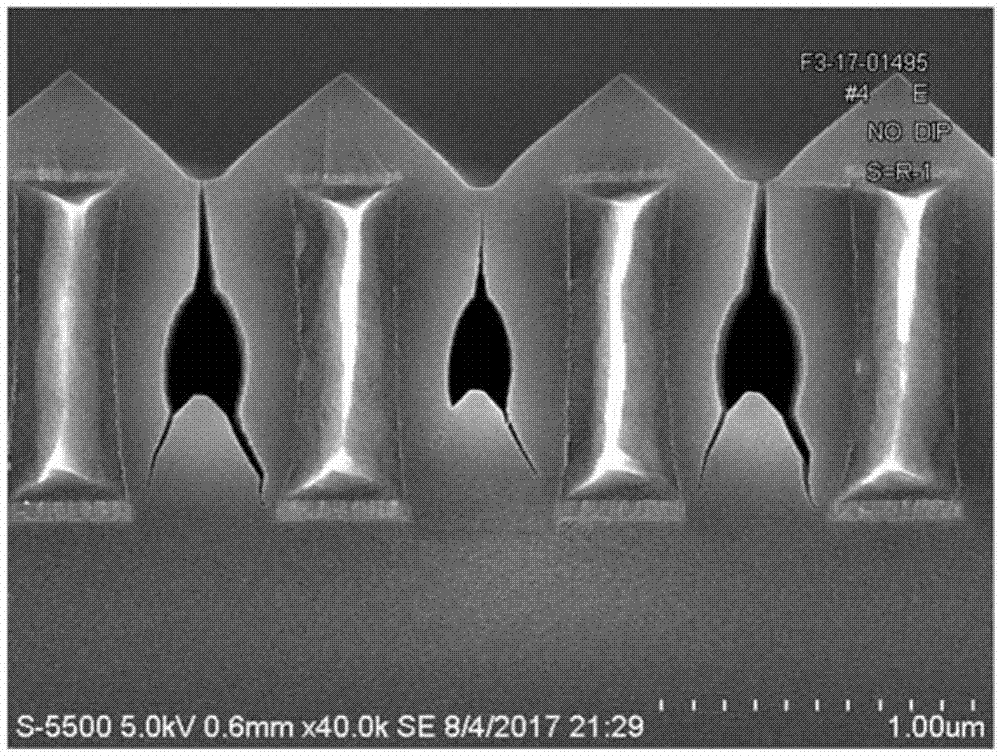 本发明涉及集成电路技术领域,特别涉及一种金属层间介质膜层的形成方法。 背景技术: 在集成电路技术的发展中面临的一个持久挑战是希望增加器件连接的金属互连的密度而不会引入它们之间的寄生等相互作用,一般通过提供填充有电绝缘材料的间隔或沟槽来物理地和电性隔离相应器件,防止所不希望出现的相互作用。 然而,如图1所示为在金属层间形成的介质膜层在电子显微镜下的示意图,随着电路密度的增大,这些间隔的宽度减小,从而增大了其深宽并使得难以实现填充这些间隔,并由于现有技术的工艺腔体中高偏压与高等离子体浓度的环境中,容易发生电荷在晶圆上积聚的情况,导致金属层之间发生电弧击穿(arcing),一旦发生,就可导致晶圆报废。 因此,如何更好的提供一种防止金属层间发生电弧击穿的金属层间介质膜层的形成方法是本领域技术人员亟待解决的一个技术问题。 技术实现要素: 本发明的目的在于提供一种金属层间介质膜层的形成方法,以解决现有技术中金属层间发生电弧击穿的问题。 为解决上述技术问题,本发明提供一种金属层间介质膜层的形成方法,所述金属层间介质膜层的形成方法包括: 提供一晶圆,所述晶圆表面具有金属层,所述金属层具有深宽比为0.4~0.675的间隔; 在所述金属层上进行第一步沉积,所述第一步沉积的偏置射频的功率为2200w~2600w,所述第一步沉积采用的气体包括硅烷和氧气,所述第一步沉积形成的介质膜层的厚度为所需介质膜层厚度的60%~90%,所述第一步沉积在所述间隔中形成间隙; 在所述金属层上进行第二步沉积,所述第二步沉积的偏置射频的功率高于所述第一步沉积的偏置射频的功率,所述第二步沉积采用的气体也包括硅烷和氧气,所述第二步沉积中的硅烷的气体流量以及氧气的气体流量均低于所述第一步沉积中的硅烷的气体流量以及氧气的气体流量。 可选的,在所述金属层间介质膜层的形成方法中,所述第二步沉积的偏置射频的功率高于所述第一步沉积的偏置射频的功率在10%以内。 可选的,在所述金属层间介质膜层的形成方法中,所述第二步沉积中的硅烷的气体流量以及氧气的气体流量均低于所述第一步沉积中的气体流量在10%以上。 可选的,在所述金属层间介质膜层的形成方法中,所述第一步沉积中的硅烷的气体流量为50sccm~70sccm,气体的气体流量为110sccm~140sccm。 可选的,在所述金属层间介质膜层的形成方法中,所述第一步沉积的沉积溅射比d/s为5.0~7.0,所述第二步沉积的沉积溅射比d/s为1.8~3.8。 可选的,在所述金属层间介质膜层的形成方法中,所述第一步沉积形成的介质膜层的厚度为 可选的,在所述金属层间介质膜层的形成方法中,所述第一步沉积和所述第二步沉积均还包括上部射频和侧部射频,上部射频的功率为1100w~1500w,侧部射频的功率为2800w~3500w。 可选的,在所述金属层间介质膜层的形成方法中,所述第一步沉积和所述第二步沉积的介质膜层包括富硅氧化层。 可选的,在所述金属层间介质膜层的形成方法中,还包括:在第二步沉积后对所述晶圆的表面进行化学机械研磨。 综上所述,在本发明提供的金属层间介质膜层的形成方法中,对于具有间隔的金属层分两步进行沉积介质膜层,在第一步沉积在采用较弱的偏置射频可快速生长二氧化硅并在间隔中形成间隙,可起到保护金属的作用,在第二步沉积的偏置射频的功率高于第一步沉积的偏置射频的功率,同时降低反应气体的气体流量,从而具有较佳的填充能力可控制间隙高度,使得间隙高度低于金属高度之下,并且间隙大小也得到改善,可防止金属层间发生电弧击穿。 附图说明 图1是现有技术形成的介质膜层在电子显微镜下的示意图; 图2是本发明实施例形成的介质膜层在电子显微镜下的示意图。 具体实施方式 为了使本发明的目的、特征和优点能够更加明显易懂,请参阅附图。须知,本说明书所附图式所绘示的结构、比例、大小等,均仅用以配合说明书所揭示的内容,以供熟悉此技术的人士了解与阅读,并非用以限定本发明可实施的限定条件,故不具技术上的实质意义,任何结构的修饰、比例关系的改变或大小的调整,在不影响本发明所能产生的功效及所能达成的目的下,均应仍落在本发明所揭示的技术内容得能涵盖的范围内。 参考如图2所示,本发明提供一种金属层间介质膜层的形成方法,所述金属层间介质膜层的形成方法包括: 提供一晶圆,所述晶圆表面具有金属层,所述金属层具有深宽比为0.4~0.675的间隔,金属层可以是在刻蚀后形成的版图,例如形成一定间距的金属线结构等,可实现后续器件结构的电性连接关系,金属层的材料包括铜或铝等; 在所述金属层上进行第一步沉积,所述第一步沉积的偏置射频(biasrf)的功率为2200w~2600w,所述第一步沉积采用的气体包括硅烷和氧气,所述第一步沉积形成的介质膜层的厚度为所需介质膜层厚度的60%~90%,所需介质膜层厚度即为工艺设计所要求的覆盖金属层间隔的厚度范围,所述第一步沉积在所述间隔中形成间隙; 在所述金属层上进行第二步沉积,所述第二步沉积的偏置射频的功率高于所述第一步沉积的偏置射频的功率,所述第二步沉积采用的气体也包括硅烷和氧气,所述第二步沉积中硅烷的气体流量以及氧气的气体流量均低于所述第一步沉积中的硅烷的气体流量以及氧气的气体流量。 在本实施例中,所述第二步沉积的偏置射频的功率高于所述第一步沉积的偏置射频的功率在10%以内,即功率超出部分在10%以内,偏置射频可使金属层表面的介质膜层分离开,也就是在偏置射频的作用下蚀刻介质膜层,由于在第二步沉积中采用较高功率的偏置射频,配合较低的气体流量,从而达到能够控制间隙高度的填充能力,使得间隔中形成的间隙高度在金属高度之下,并能改善间隙大小。 相应的,所述第二步沉积中的硅烷的气体流量以及氧气的气体流量均低于所述第一步沉积中的气体流量在10%以上,即气体流量减少部分超过10%,通过减少气体流量控制间隙封口使得更好的形成间隙。 在本申请例中,所述第一步沉积中的硅烷的气体流量为50sccm~70sccm,氧气的气体流量为110sccm~140sccm,相对应的,由于在第二步沉积中采用低于所述第一步沉积中的硅烷的气体流量以及氧气的气体流量,可相应的得出第二步沉积中气体的流量,第二步沉积中气体的流量可在第二步沉积中气体的流量的90%以内。 可选的,所述第一步沉积的沉积溅射比d/s(deposition/sputterratio)为5.0~7.0,所述第二步沉积的沉积溅射比d/s为1.8~3.8,第一步沉积中采用高沉积溅射比,在溅射较弱的条件下可快速生长介质膜层,可起到保护金属层的作用,第二步沉积中采用低沉积溅射比,保证填充能力改善形成的间隙。 对应于金属层的间隔深度,所述第一步沉积形成的介质膜层的厚度为在第一步沉积形成的介质膜层的厚度为所需介质膜层厚度的60%~90%,剩余所需厚度介质膜层在第二步沉积中形成,通过第一步沉积快速的生长并初步在间隔中形成间隙,并可通过在第二步沉积不同的偏置功率以及气体流量中实现间隔的封口。 在本实施例中,所述第一步沉积和所述第二步沉积均还包括上部射频(toprf)和侧部射频(siderf),上部射频的功率为1100w~1500w,侧部射频的功率为2800w~3500w,通过上部射频和侧部射频实现腔体中高等离子体浓度的工艺环境,并可在第一步沉积和第二步沉积中采用相同设置的功率范围,本发明的方案在于调整偏置射频以及气体流量以较佳的实现金属层间介质膜层的形成,防止金属层间发生电弧击穿。 根据本发明的方案,所述第一步沉积和所述第二步沉积的介质膜层包括富硅氧化层(sro),富硅氧化层具有高si/o比例,提供较佳的电学特性。 在本实施例中,所述金属层间介质膜层的形成方法还包括:在第二步沉积后对所述晶圆的表面进行化学机械研磨,使得形成的介质膜层平坦化满足平坦度的要求。 综上所述,在本发明提供的金属层间介质膜层的形成方法中,对于具有间隔的金属层分两步进行沉积介质膜层,在第一步沉积在采用较弱的偏置射频可快速生长二氧化硅并在间隔中形成间隙,可起到保护金属的作用,在第二步沉积的偏置射频的功率高于第一步沉积的偏置射频的功率,同时降低反应气体的气体流量,从而具有较佳的填充能力可控制间隙高度,使得间隙高度低于金属高度之下,并且间隙大小也得到改善,可防止金属层间发生电弧击穿。 上述描述仅是对本发明较佳实施例的描述,并非对本发明范围的任何限定,本发明领域的普通技术人员根据上述揭示内容做的任何变更、修饰,均属于权利要求书的保护范围。 |
【本文地址】