一种半导体的涂布设备及涂布方法与流程 |
您所在的位置:网站首页 › 一种涂布机及涂布方法 › 一种半导体的涂布设备及涂布方法与流程 |
一种半导体的涂布设备及涂布方法与流程
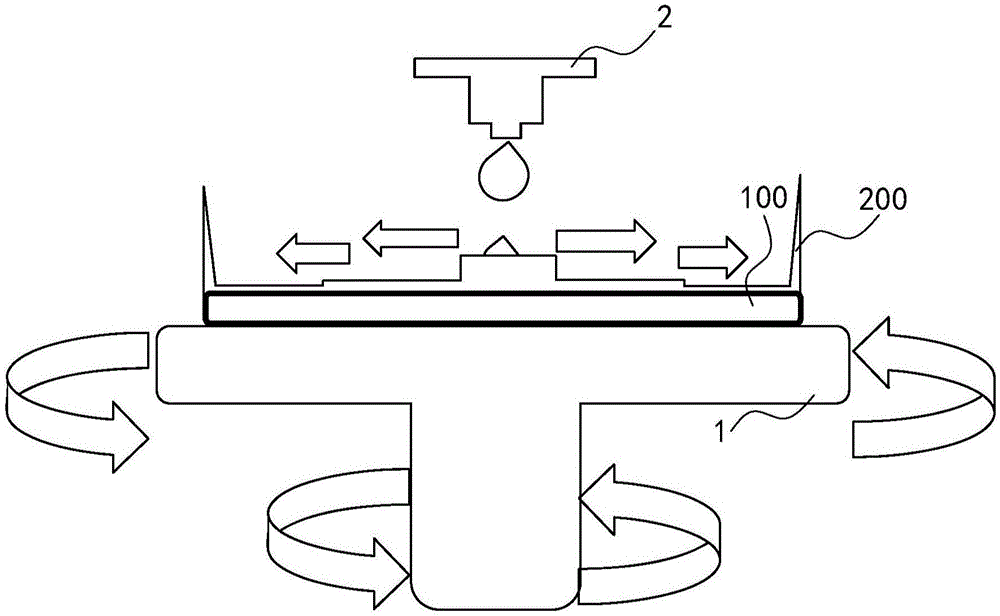 本发明涉及半导体制造领域,特别涉及半导体的涂布设备及涂布方法。 背景技术: 在半导体制程中,包括在晶圆上形成微米厚度等级的薄膜层,通常采取的方式是利用涂布机以旋转离心的方式将液态旋涂材料,例如光阻剂,均匀地在晶片表面上形成薄膜层。 图1示出了一种现有的涂布机,其包括用于放置并旋转晶圆100的涂布平台1和用来将旋涂溶液提供至晶圆表面的流体供应系统2。 涂布时,将旋涂溶液经由流体供应系统倒到晶圆表面中心位置,并旋转涂布平台,旋涂溶液通过旋转产生的离心力均匀涂布在晶圆表面形成薄膜层。 然而,旋转过程中,由于粘合力的作用,旋涂溶液容易积累在晶圆100的最外缘(晶边),随着积累厚度的逐渐增大,最终会在晶圆的最外缘形成脊状的凸起200,即为晶边悬突效应。在后续的抛光过程中,这些凸起会首先接触抛光垫,而被切断,导致晶圆表面的断裂处出现划痕,由此影响产品的良率。 因此,如何对现有的涂布设备进行改进,以提高晶圆厚度的均匀性和表面平整度,提高产品的良率,实为半导体制造领域亟待解决的问题。 技术实现要素: 基于上述问题,本发明提供了一种半导体的涂布设备及涂布方法,其能够提高晶圆厚度的均匀性和表面平整度,提高产品的良率。 为达成上述目的,本发明提供一种半导体的涂布方法,包括:将晶圆放置于涂布平台;将旋涂材料提供至所述晶圆表面,使所述晶圆在第一涂布阶段内旋转,第一涂布阶段的时间为不少于2s;使所述晶圆在第二涂布阶段内继续旋转,第二涂布阶段的时间为不大于30s;及使所述晶圆在第三涂布阶段内继续旋转至涂布完毕;其中,所述第二涂布阶段的转速为1000rpm-2500rpm。 根据一实施例,晶圆在所述第一涂布阶段的转速为大于0rpm且小于1800rpm。 根据一实施例,所述第一涂布阶段包括加速阶段和减速阶段,所述加速阶段的转速v1的范围为0rpm<v1≤1800rpm,所述减速阶段的转速v2的范围为1000rpm≤v2<v1。 根据一实施例,所述第二涂布阶段包括匀速阶段和加速阶段,所述匀速阶段的时间25s~28s,所述加速阶段的时间为2-5s。 根据一实施例,所述匀速阶段转速v3不小于1000rpm,所述加速阶段的最大转速v4不大于2000rpm。 根据一实施例,所述第二涂布阶段包括加速阶段、匀速阶段以及减速阶段,所述加速阶段持续时间为2-3s,所述匀速阶段持续时间为25-26s,所述减速阶段持续时间为1-3s。 根据一实施例,所述加速阶段包括第一加速期、第二加速期以及衔接第一加速期和第二加速期的过渡期,所述第一加速期持续时间为0.5-0.8s,所述过渡期持续时间为1-1.4s,所述第二加速期持续时间为0.5-0.8s。 根据一实施例,所述第一加速期的转速v5的范围为1000rpm≤v5≤2000rpm,所述过渡期的转速v6的范围为v5<v6<2000rpm,所述第二加速期的转速v7的范围为v6<v7≤2500rpm。 根据一实施例,所述匀速阶段的转速v8不大于2500rpm。 根据一实施例,所述减速阶段的转速v9的范围为2000rpm≤v9<v8。 根据一实施例,所述第三涂布阶段包括匀速期,所述匀速期持续时间为15-20s。 根据一实施例,所述第三涂布阶段的匀速期的转速v10的范围为1000rpm≤v10≤2000rpm。 本发明另一方面,提供一种半导体的涂布设备,包括: 涂布平台,用于放置晶圆,并通过驱动部使晶圆旋转; 流体供应系统,用于将旋涂材料提供至晶圆表面;及 控制系统,用于控制驱动部的旋转速度,使所述晶圆在第一涂布阶段内旋转,第一涂布阶段的时间为不少于2s;使所述晶圆在第二涂布阶段内继续旋转,第二涂布阶段的时间为不大于30s;及使所述晶圆在第三涂布阶段内继续旋转至涂布完毕; 其中,所述第二涂布阶段的转速为1000rpm-2500rpm。 本发明相较于现有技术的有益效果在于:本发明通过控制涂布平台的旋转速度,使得晶圆表面所涂布形成的膜厚均匀,有效降低发生晶边悬突的风险,使得晶圆厚度的均匀性和表面平整度大幅提高,从而提升产品的良率。 附图说明 图1为现有技术的半导体的涂布机的示意图。 图2为通过现有技术的半导体的涂布机进行涂布后的晶圆进行抛光工艺的示意图。 图3为本公开一实施例的半导体的涂布设备的示意图。 图4为本公开一实施例的半导体的涂布设备的涂布时间与转速的曲线图。 图5为本公开一实施例的半导体的涂布设备的转速与膜厚的曲线图。 图6为分别利用本公开一实施例与现有技术的半导体的涂布设备进行涂布后,晶圆半径与膜厚的对比曲线图。 图7a和图7b分别为本公开一实施例与现有技术的半导体的涂布设备进行涂布后晶圆的示意图。 具体实施方式 现在将参考附图更全面地描述示例实施方式。然而,示例实施方式能够以多种形式实施,且不应被理解为限于在此阐述的实施方式;相反,提供这些实施方式使得本发明更全面和完整,并将示例实施方式的构思全面地传达给本领域的技术人员。在图中,为了清晰,可能夸大了区域和层的厚度。在图中相同的附图标记表示相同或类似的结构,因而将省略它们的详细描述。 此外,所描述的特征、结构或特性可以以任何合适的方式结合在一个或更多实施例中。在下面的描述中,提供许多具体细节从而给出对本发明的实施例的充分理解。然而,本领域技术人员将意识到,可以实践本发明的技术方案而没有所述特定细节中的一个或更多,或者可以采用其它的方法、组元、材料等。在其它情况下,不详细示出或描述公知结构、材料或者操作以避免模糊本发明的主要技术创意。 本发明提供一种半导体的涂布方法,参照图4,其包括: 将晶圆放置于涂布平台; 将旋涂材料提供至所述晶圆表面,使所述晶圆在第一涂布阶段t1内旋转,第一涂布阶段t1的时间为不少于2s; 使所述晶圆在第二涂布阶段t2内继续旋转,第二涂布阶段t2的时间为不大于30s;及 使所述晶圆在第三涂布阶段t3内继续旋转至涂布完毕; 其中,所述第二涂布阶段t2的转速为1000rpm-2500rpm。 上述方法可应用于一种半导体的涂布设备,其中,如图3所示,半导体的涂布设备可包括涂布平台10、流体供应系统20及控制系统。 涂布平台10用于放置晶圆100,并通过驱动部(未示出)使晶圆100旋转。流体供应系统20用于将旋涂材料提供至晶圆表面。控制系统用于控制驱动部的旋转速度,使晶圆100在第一涂布阶段t1内旋转,第一涂布阶段t1的时间为不少于2s;使晶圆100在第二涂布阶段t2内继续旋转,第二涂布阶段t2的时间为不大于30s;及使晶圆100在第三涂布阶段t3内继续旋转至涂布完毕;其中,第二涂布阶段的转速为1000rpm-2500rpm。 如图4的处理时间与转速的曲线图所示,晶圆100首先在第一涂布阶段t1内旋转,接着,在第二涂布阶段t2内继续旋转,第二涂布阶段的时间为不大于30s,第二涂布阶段的转速为1000rpm-2500rpm,此后,晶圆100在第三涂布阶段t3内继续旋转至达到所需膜厚。 如图5所示,如曲线l6所示,在第二涂布阶段的转速处于为1000rpm~2500rpm范围内时,膜厚的变化较均匀,而在上述第二涂布阶段的转速范围之外时,膜厚的变化波动大。 如曲线l7所示,在第二涂布阶段的转速处于为1000rpm~2500rpm范围内时,晶圆膜厚的差值(晶圆上所涂薄膜的最大厚度处于最小厚度处之间的厚度差)保持在较小值,也就是说,晶圆各处的厚度基本保持一致,而在上述第二涂布阶段的转速范围之外时,晶圆膜厚的差值的变化波动大。 参照图6并配合图7a、7b,图6示出了对应于晶圆上不同半径位置所测量的膜厚,曲线l9和曲线l8分别示出了现有的和本发明的涂布方法进行旋转涂布后晶圆的膜厚。其中,图6中所圈出部分即为晶边处的膜厚。如图7a所示,采用本发明的涂布方法进行旋转涂布后的晶圆100的晶边几乎不存在凸起,而如图7b中所示,采用现有的涂布方法进行旋转涂布后的晶圆100的晶边存在明显的脊状的凸起200。 由此可见,相比于现有技术,应用本发明的涂布方法进行涂布所得的膜厚均匀,特别是晶边处,无明显厚度变化。 因此,本发明通过控制涂布平台的旋转速度,使得晶圆表面所涂布形成的膜厚均匀,有效降低发生晶边悬突的风险,使得晶圆厚度的均匀性和表面平整度大幅提高,从而提升产品的良率。 本实施例中,晶圆在第一涂布阶段t1的转速为大于0rpm且小于1800rpm。 在一实施例中,如图4所示,第一涂布阶段t1包括加速阶段和减速阶段,加速阶段的转速v1的范围为0rpm<v1≤1800rpm,减速阶段的转速v2的范围为1000rpm≤v2<v1。即,在第一涂布阶段t1,晶圆首先进行加速旋转,随后进行减速旋转,接着过渡至第二涂布阶段t2。 在一实施例中,如图4所示,第二涂布阶段t2可包括匀速阶段和加速阶段,所述匀速阶段的时间25s~28s,所述加速阶段的时间为2-5s。其中,所述匀速阶段转速v3不小于1000rpm,所述加速阶段的最大转速v4不大于2000rpm。即,本实施例中,晶圆进入第二涂布阶段t2时,先经过加速阶段,将转速提升至第二涂布阶段的转速,接着以第二涂布阶段的转速在匀速阶段内保持匀速旋转。 在另一实施例中,如图4所示,所述第二涂布阶段t2可包括加速阶段、匀速阶段以及减速阶段,所述加速阶段持续时间为2-3s,所述匀速阶段持续时间为25-26s,所述减速阶段持续时间为1-3s。即,本实施例中,晶圆进入第二涂布阶段t2时,先经过加速阶段,将转速提升至第二涂布阶段的转速,接着以第二涂布阶段的转速在匀速阶段内保持匀速旋转,最后,在减速阶段减速旋转,进入第三涂布阶段t3。 其中,所述加速阶段可包括第一加速期、第二加速期以及衔接第一加速期和第二加速期的过渡期,所述第一加速期持续时间为0.5-0.8s,所述过渡期持续时间为1-1.4s,所述第二加速期持续时间为0.5-0.8s。 其中,所述第一加速期的转速v5的范围为1000rpm≤v5≤2000rpm,所述过渡期的转速v6的范围为v5<v6<2000rpm,所述第二加速期的转速v7的范围为v6<v7≤2500rpm。 也就是说,在第二涂布阶段的加速过程中,晶圆是从第一加速期的转速v5逐渐增大至转速v7,且经历一转速较平缓的过渡期(过渡期的转速v6),可见,转速并非骤增,因此,能够确保转速增大的过程中的涂布的均匀性,以及保持晶圆的稳定性。 在其他实施例中,在第二涂布阶段的加速过程中,还可增加多个加速期及加速期之间的过渡期。 本实施例中,所述匀速阶段的转速v8不大于2500rpm。在第二涂布阶段t2的大部分阶段,晶圆是以转速v8旋转。转速v8的转速较大,转速越快,则膜层越薄,从而大幅提升涂布的均匀性,尽可能避免出现晶边悬突效应。 本实施例中,减速阶段的转速v9的范围为2000rpm≤v9<v8。例如,2000rpm≤v9≤2200rpm。即,在减速阶段,晶圆由转速v8将至转速v9,转速大致减小500rpm。也就是说,晶圆是由匀速阶段的转速v8,即,最高的转速,小幅减速至转速v9,接着进入第三涂布阶段t3,因此,速度并未骤降,从而能够确保转速减小的过程中的涂布的均匀性,以及保持晶圆的稳定性。 本实施例中,如图4所示,所述第三涂布阶段t3可包括匀速期,所述匀速期持续时间为15-20s。第三涂布阶段的匀速期的转速v10的范围为1000rpm≤v10≤2000rpm。例如可为,1500rpm,1800rpm。因此,在第二涂布阶段后的第三涂布阶段内,晶圆以较大的转速旋转较长时间,直至涂布完毕,转速降为0。由此,使得从转速最大的第二涂布阶段至转速为0的过程中,转速过渡平缓,保证涂布的均匀性,且较好的保护设备,延长使用寿命。 在一些实施例中,第三涂布阶段t3可作为后处理阶段,即,可进行相关设备的清洗,例如对涂布平台10上用于容纳晶圆的杯体进行内部和外部的清洗。在清洗过程中,保持转速v10不变,可实现均匀、全面的清洗效果。 应当理解,上述各个阶段的时间和转速仅为示例,可根据实际情况调整上述阶段的时间、转速。各个阶段的时间和转速均可以参照图4中表格所示的数据范围进行选择。 还可改变阶段内容,例如,可根据工艺需要,在涂布阶段之前或之后增加其他阶段内容。 综上所述,本发明通过控制涂布平台的旋转速度,使得晶圆表面所涂布形成的膜厚均匀,有效降低发生晶边悬突的风险,使得晶圆厚度的均匀性和表面平整度大幅提高,从而提升产品的良率。 虽然已参照几个典型实施例描述了本发明,但应当理解,所用的术语是说明和示例性、而非限制性的术语。由于本发明能够以多种形式具体实施而不脱离发明的精神或实质,所以应当理解,上述实施例不限于任何前述的细节,而应在随附权利要求所限定的精神和范围内广泛地解释,因此落入权利要求或其等效范围内的全部变化和改型都应为随附权利要求所涵盖。 |
【本文地址】
今日新闻 |
点击排行 |
|
推荐新闻 |
图片新闻 |
|
专题文章 |