| 陶瓷基板DBC和AMB铜基板技术流程介绍 | 您所在的位置:网站首页 › 钎焊焊接工艺流程视频 › 陶瓷基板DBC和AMB铜基板技术流程介绍 |
陶瓷基板DBC和AMB铜基板技术流程介绍

 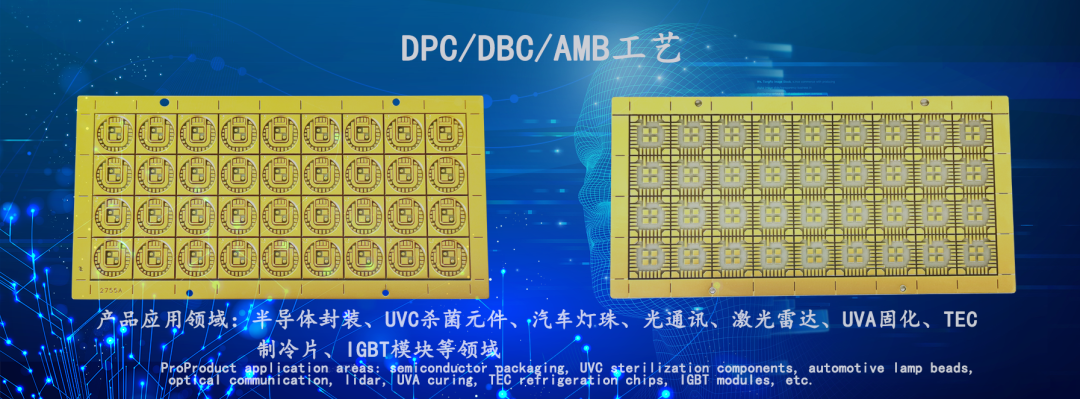
这些年来,随着功率半导体的快速发展,在第三代半导体碳化硅芯片具有禁带宽度带、热导率高等特点。作为陶瓷基板芯片载体被应用于承载芯片并在终端客户应用中连接到水冷系统(焊接或烧结),以达到芯片所需的高散热、可靠性和绝缘性能。 目前,基于陶瓷铜基板的新型功率半导体模块已在意法半导体、英飞凌、安森美等各大半导体公司投入量产。业界对陶瓷铜基板的需求和质量要求越来越高,因此半导体行业的工程师迫切需要了解陶瓷铜基板的制造工艺和应用风险。本文介绍市场上两种主流的陶瓷铜基板加工方法: 
一 DBC直接键合铜和AMB 活性金属钎焊工艺介绍
 AMB陶瓷基板中的结合是通过陶瓷和活性金属钎料在温度下的化学反应实现的,与传统的AI2O3陶瓷基板相比,AMB中使用的Si3N4陶瓷具有更高的热导率(>90W/mK 25℃),更接近硅的热膨胀系数(2.6x10 -6 /K)。因此,AMB基板具有较高的粘合强度和可靠性。结合银烧结工艺和大功率碳化硅芯片,带有活性金属涂层的AMB铜层可以实现高功率、更好的散热和高可靠性的封装模块(可承受3000次热冲击),已广泛应用于电动汽车、电力机车和高速列车。DBC和AMB的性能对比如图1所示。
AMB陶瓷基板中的结合是通过陶瓷和活性金属钎料在温度下的化学反应实现的,与传统的AI2O3陶瓷基板相比,AMB中使用的Si3N4陶瓷具有更高的热导率(>90W/mK 25℃),更接近硅的热膨胀系数(2.6x10 -6 /K)。因此,AMB基板具有较高的粘合强度和可靠性。结合银烧结工艺和大功率碳化硅芯片,带有活性金属涂层的AMB铜层可以实现高功率、更好的散热和高可靠性的封装模块(可承受3000次热冲击),已广泛应用于电动汽车、电力机车和高速列车。DBC和AMB的性能对比如图1所示。
二 主要工艺技术流程陶瓷铜基板的整体工艺流程如下:第一:对供应的铜和陶瓷进行表面处理;第二:将铜和陶瓷堆叠起来,放入真空高温炉中进行焊接;第三:对陶瓷表面的铜进行化学蚀刻,生成设计好的图案和线条;第四:用激光切割陶瓷基板,进行单片化,得到单芯。 DBC和AMB产品主要有两点区别:第一,DBC产品的铜和陶瓷是直接粘合的,而AMB产品的铜和陶瓷是用活性金属钎料钎焊的,需要额外的丝印工艺。钎焊前进行,将活性金属钎料均匀地置于陶瓷基板上;其次,DBC产品的铜是通过一次蚀刻形成的,而对于带有额外金属钎焊层的AMB产品,则需要进行额外的蚀刻工艺去除钎料,通常采用氢氟酸。
以AMB产品为例,陶瓷铜基板的工艺流程如图2所示,下面将详细介绍主要工艺和材料。 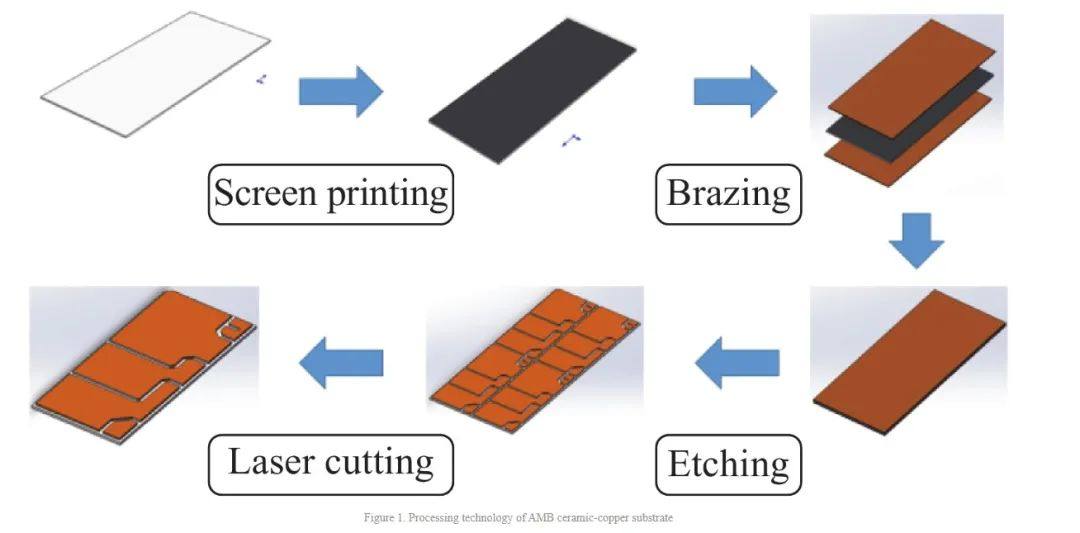
1 原材料 陶瓷铜基板的直接原材料主要有铜带和陶瓷基板,以及特殊的活性金属钎料(以AMB为例)。 铜带:目前在工业上广泛采用Cu-OFE(含铜>99.99%,氧 |
【本文地址】
公司简介
联系我们

 1、直接键合铜
1、直接键合铜 2、活性金属钎焊
2、活性金属钎焊