| 先进封装之面板级封装(Panel Level Package,PLP) | 您所在的位置:网站首页 › plp是什么 › 先进封装之面板级封装(Panel Level Package,PLP) |
先进封装之面板级封装(Panel Level Package,PLP)
|
大家都知道整个封装界的升维之路上:从2D封装到2.5D再到3D封装(备注:各种封装形式差异可参看艾邦半导体公众号)。Chiplet级的封装如果以载体的形式来分则分为两种:晶圆级封装(Wafer level package, WLP)和面板级封装(Panel level package, PLP)。根据载体的材料来分可以归为三类:有机物基板、硅基板、玻璃基板。特别申明:本文封装特指扇出型封装。
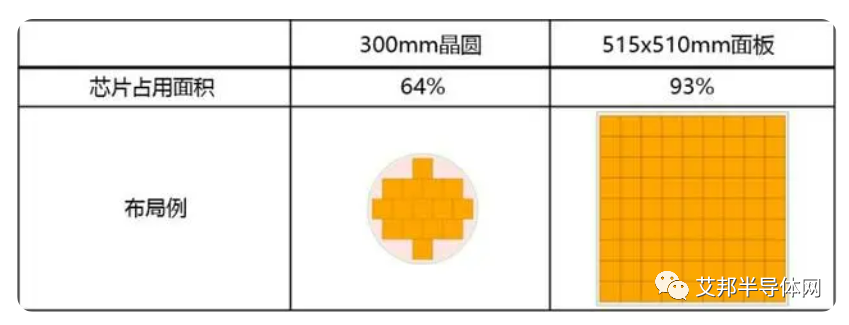 图2 晶圆级封装及面板级封装芯片占用面积比
图2 晶圆级封装及面板级封装芯片占用面积比
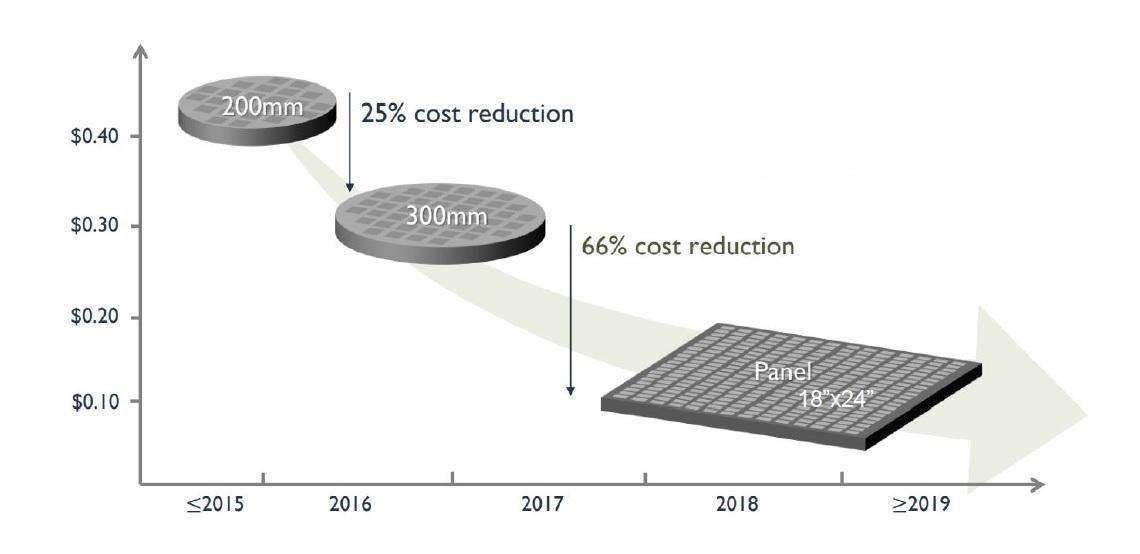 图3 from Yole
面板级封装工艺流程与晶圆级封装本身没有太大差异。但是由于载体不同,需要独立开发生产设备及相应系统。下面简单介绍一下当前设备供应商对面板级封装的开发情况:
在面板级封装光刻机领域,日本佳能动作非常快,佳能在错失超紫外光刻机的机遇后,不会再放过任何一个机会。如图4所示,佳能在2020年7月推出型号为FPA-8000iW的光刻机,具备对应尺寸最大到515×510mm大型方形基板的能力以及1.0微米3的高解像力。
图3 from Yole
面板级封装工艺流程与晶圆级封装本身没有太大差异。但是由于载体不同,需要独立开发生产设备及相应系统。下面简单介绍一下当前设备供应商对面板级封装的开发情况:
在面板级封装光刻机领域,日本佳能动作非常快,佳能在错失超紫外光刻机的机遇后,不会再放过任何一个机会。如图4所示,佳能在2020年7月推出型号为FPA-8000iW的光刻机,具备对应尺寸最大到515×510mm大型方形基板的能力以及1.0微米3的高解像力。
 图4 佳能FPA-8000iW光刻机
在面板级封装RDL工艺领域,Manz是领跑者之一,2016年Manz开始进军半导体先进封装领域,2017年研发并售出第一台用于半导体先进封装FOPLP的湿法化学设备,并于2019年交付首条半导体板级封装全自动RDL生产线,面板尺寸也从515mm x 510mm开始,演进至600mm x 600mm,直至2022年升级至业界最大的700mm x 700mm面板,并克服了面板翘曲问题,见图5。Manz生产设备已出货全球知名半导体制造商,应用于车载与射频芯片的封装量产。Manz新一代面板级封装 RDL生产线,在制程上接续干膜制程,完成线路成型,其均匀性以及填孔能力分别表现在线宽线距可至 ≥10μm及盲孔孔径≥25μm;
图4 佳能FPA-8000iW光刻机
在面板级封装RDL工艺领域,Manz是领跑者之一,2016年Manz开始进军半导体先进封装领域,2017年研发并售出第一台用于半导体先进封装FOPLP的湿法化学设备,并于2019年交付首条半导体板级封装全自动RDL生产线,面板尺寸也从515mm x 510mm开始,演进至600mm x 600mm,直至2022年升级至业界最大的700mm x 700mm面板,并克服了面板翘曲问题,见图5。Manz生产设备已出货全球知名半导体制造商,应用于车载与射频芯片的封装量产。Manz新一代面板级封装 RDL生产线,在制程上接续干膜制程,完成线路成型,其均匀性以及填孔能力分别表现在线宽线距可至 ≥10μm及盲孔孔径≥25μm;
 图5 Manz集团亚洲区总经理 林峻生先生展示以Manz新一代面板级封装 RDL自动化生产线所试制之产品
在面板级晶粒贴装领域,ASMPT,华封等都有相应产品。其相关产品根据UPH不同都可以达到2.5~7微米精度。基本可以满足大多数封装产品的需求。
图5 Manz集团亚洲区总经理 林峻生先生展示以Manz新一代面板级封装 RDL自动化生产线所试制之产品
在面板级晶粒贴装领域,ASMPT,华封等都有相应产品。其相关产品根据UPH不同都可以达到2.5~7微米精度。基本可以满足大多数封装产品的需求。
二、当前需求量还较低,设备供应商没有特别高的热情来冒险开发整条产线。 三、初期产品还仅限于低密度产品,并没有发挥出面板级封装的低成本优势。 四、业界希望面板级封装芯粒与芯粒间的间距可以达到2微米,而当前量产的产品其晶粒与晶粒间的间距最低可以达到5微米。 五、面板级封装还需要开发特殊的检测及测量工具。 六、面板级封装与当前晶圆级封装数据系统不完全兼容,还需进行一定的改造。 这也是为什么大厂台积电至今也没有意向开发面板级封装。英特尔虽然也尝试面板级封装但是没有用于fan out。总之,面板级封装技术被广泛使用仍需时日,需要大量的前期投资来打造完整的产业生态链。 作者:Sem Sol & Mr Shu 参考网址及文献: 1.https://baijiahao.baidu.com/s?id=1670269168270249241&wfr=spider&for=pc 2.https://www.eet-china.com/news/202212137784.html 3.https://www.manz.com/cn/company/news/manz-45/ 4.https://semiengineering.com/planning-for-panel-level-fan-out/原文始发于微信公众号(艾邦半导体网):先进封装之面板级封装(Panel Level Package,PLP) |
【本文地址】
公司简介
联系我们